隨著智能手機(jī)����、5G�、物聯(lián)網(wǎng)等技術(shù)的快速發(fā)展,芯片的發(fā)熱功率急劇上升�,與此同時(shí),手機(jī)等設(shè)備外觀要求超薄����,導(dǎo)致設(shè)計(jì)上的散熱空間極為有限�����,芯片溫度控制難度極大����。熱應(yīng)力容易導(dǎo)致CSP芯片晶圓翹曲����,嚴(yán)重時(shí)會(huì)產(chǎn)生開裂現(xiàn)象。
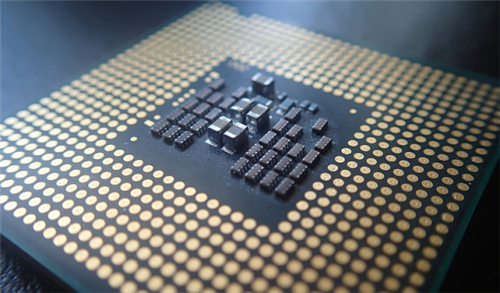
由于手機(jī)芯片尺寸較小�,在溫度循環(huán)下的熱應(yīng)力較難通過(guò)傳統(tǒng)的應(yīng)變測(cè)試方法獲取,因此需要采用DIC技術(shù)的方法進(jìn)行應(yīng)變測(cè)量����,從而更好地分析芯片通電后的熱應(yīng)力分布情況,分析芯片導(dǎo)電��、溫度控制�����、散熱等相關(guān)性能���。
新拓三維XTDIC應(yīng)變測(cè)量分析系統(tǒng)�����,作為研究芯片在不同溫度下變形分析的重要測(cè)量工具����,特別適用于分析芯片在負(fù)荷狀態(tài)下產(chǎn)生熱應(yīng)力及應(yīng)力集中問(wèn)題,從而更好地考察芯片在工作狀態(tài)下的可靠性和穩(wěn)定性�����。
顯微DIC芯片受熱膨脹實(shí)驗(yàn)
環(huán)境條件對(duì)芯片可靠性有很大影響��,特別是溫度過(guò)熱后�,會(huì)出現(xiàn)材料軟化���,結(jié)構(gòu)強(qiáng)度減弱�����,材料電性能變化���,甚至損壞���;設(shè)備過(guò)熱,元件損壞����,金屬材料表面電阻增大等,從而造成芯片無(wú)法高效工作���。因此芯片的熱效應(yīng)分析非常重要����。
如下圖所示���,在通電受熱狀態(tài)下芯片應(yīng)變分布特性:
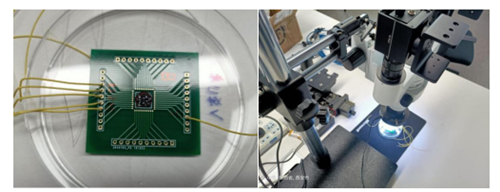
顯微DIC系統(tǒng)進(jìn)行圖像采集

芯片通電受熱膨脹變形分析

關(guān)鍵點(diǎn)區(qū)域應(yīng)變分布曲線
研究?jī)?nèi)容及關(guān)鍵點(diǎn):
顯微DIC系統(tǒng)專利的算法可精確測(cè)量在顯微鏡下芯片的細(xì)微變形和應(yīng)變��;
顯微DIC系統(tǒng)可通過(guò)應(yīng)變?cè)茍D直接提取溫度疲勞載荷過(guò)程中影響區(qū)域的分布特性�,作為失效判定依據(jù)����;
顯微DIC系統(tǒng)應(yīng)變分析數(shù)據(jù)結(jié)果?,可直接用于不同材料熱膨脹系數(shù)判斷依據(jù)���;
可直接測(cè)量PCB熱變形引起的開膠等失效位置和應(yīng)變梯度�;
手機(jī)芯片高低溫變形實(shí)驗(yàn)
高低溫幾乎對(duì)所有的基本材料都有不利的影響,對(duì)于暴露于異常溫度下的電子設(shè)備����,由于溫度會(huì)改變其組成材料的物理特性,因此可能會(huì)改變其工作性能�,對(duì)手機(jī)功能造成暫時(shí)或永久的損害。
?材料的軟化�����、硬化和脆化
?不同材料的收縮不一致
?電子器件(芯片�、電阻、電容)性能改變
?破裂�、開裂和脆裂,沖擊強(qiáng)度改變��,強(qiáng)度降低
?芯片和PCB板性能改變
試驗(yàn)測(cè)試在不同溫度下芯片以及PCB板表面應(yīng)變情況����,分析其對(duì)于手機(jī)性能的影響���。
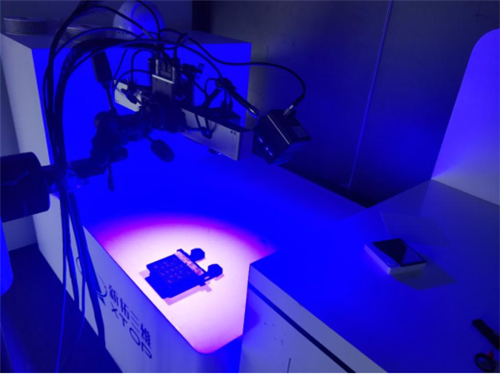
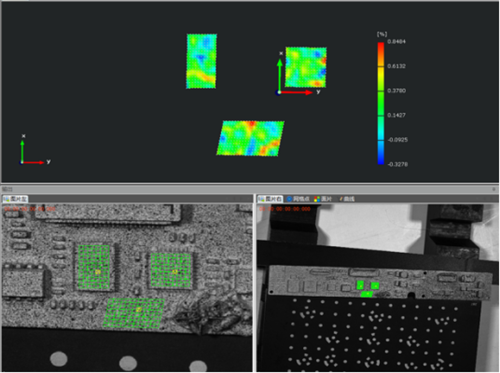

溫度變化全過(guò)程關(guān)鍵點(diǎn)應(yīng)變曲線
研究?jī)?nèi)容及關(guān)鍵點(diǎn):
DIC技術(shù)可測(cè)量芯片全場(chǎng)應(yīng)變��,以及溫度變化過(guò)程中的應(yīng)變分布變化�����;
DIC應(yīng)變?cè)茍D可直接作為判斷關(guān)鍵區(qū)域變形以及材料工藝選擇依據(jù)���;
可通過(guò)DIC技術(shù)獲取的應(yīng)變和應(yīng)變速率變化��,作為驗(yàn)證有限元分析數(shù)據(jù)依據(jù)�����;
新拓三維XTDIC系統(tǒng)在芯片工藝測(cè)試應(yīng)用:可直接測(cè)量芯片及材料熱膨脹系數(shù)��,其測(cè)量過(guò)程中新拓三維自主研發(fā)的算法并結(jié)合顯微技術(shù)�����,為測(cè)試精度提供精確保證����。XTDIC系統(tǒng)可直接測(cè)量芯片微變形����、硅片、封裝�����、基板及材料等熱變形效應(yīng)。測(cè)量芯片在不同溫度下的力學(xué)特性����,如高溫、低溫測(cè)試���,變形應(yīng)變分布和應(yīng)變集中位置����。