DIC測試背景
在集成電路和其他硅器件的高溫工藝中,單晶硅熱變形和翹曲是普遍存在的現(xiàn)象����,是器件工藝中最重要�、最困難的問題之一。硅片翹曲會給復(fù)雜線路圖的光刻工藝帶來困難�����,使器件成品率和性能受到很大影響���。
采用新拓三維XTDIC三維全場應(yīng)變測量系統(tǒng)�,搭配溫度控制箱�����,可用于高溫環(huán)境下的單晶硅熱變形測試��,DIC技術(shù)通過追蹤獲取單晶硅材料表面的散斑圖像��,解算出在各個變形狀態(tài)下單晶硅表面的位移場分布情況�����,分析單晶硅材料熱變形以及翹曲情況。

DIC測試對象
測試單晶硅材料尺寸為6英寸(直徑150mm毫米���,厚度1mm)��。

DIC測試目的
單晶硅材料于恒溫溫箱內(nèi)升溫���,采用XTDIC三維全場應(yīng)變測量系統(tǒng)測試樣件全場位移場分布情況,以向客戶提供全場位移及變形數(shù)據(jù)結(jié)果��。
熱變形測試方法
單晶硅試樣在溫控箱中����,從0℃~150℃升溫過程中,每隔10°采集分析�����,5°C/min��,分析單晶硅樣件各個溫度階段位移場分布�。
測量單晶硅尺寸較大�,相較于以往顯微分析或者小分辨率鏡頭的測試�,DIC技術(shù)分析數(shù)據(jù)準(zhǔn)確度可能會受幅面影響����,需觀察靜態(tài)數(shù)據(jù)分布是否均勻。
為了驗證XTDIC系統(tǒng)數(shù)據(jù)準(zhǔn)確性���,進(jìn)行靜態(tài)精度驗證����,以及通過高溫消除應(yīng)力�����、內(nèi)外循環(huán)風(fēng)扇干擾�,對比分析測試變形數(shù)據(jù),保證和提升在高溫環(huán)境下測試的可行性和準(zhǔn)確性�����。
DIC測試精度驗證策略
1���、DIC測試靜態(tài)精度驗證
將XTDIC三維全場應(yīng)變測量系統(tǒng)調(diào)整至測試位置����,驗證過程實時對光源、相機(jī)角度����、相機(jī)間距、測量距離等內(nèi)容進(jìn)行調(diào)整(保證采集數(shù)據(jù)不受設(shè)備本身精度影響)
靜態(tài)精度驗證數(shù)據(jù)
XTDIC三維全場應(yīng)變測量系統(tǒng)于最佳測試位置處靜態(tài)采集5張圖像��,分析單晶硅試樣最大主應(yīng)變���,實測數(shù)據(jù):最大主應(yīng)變不超過20μe�����,DIC測試精度達(dá)到理想狀態(tài)�。

2��、高溫消除應(yīng)力
將被測物放置于溫箱內(nèi)���,升高溫度至200℃�����。保溫30min以上,以消除材料自身應(yīng)力,溫度達(dá)到后���,自然冷卻至室溫��。(避免材料自身應(yīng)力對數(shù)據(jù)產(chǎn)生干擾)
3��、內(nèi)循環(huán)風(fēng)扇干擾
由于內(nèi)循環(huán)風(fēng)扇與溫箱為剛性連接���,所以溫箱會受到風(fēng)扇振動的干擾。通過分析關(guān)閉風(fēng)扇后多長時間數(shù)據(jù)最穩(wěn)定�,作為DIC圖像采集段。(排除內(nèi)部風(fēng)扇干擾以及內(nèi)部高溫氣流干擾)
內(nèi)循環(huán)風(fēng)扇擾動測試數(shù)據(jù)
關(guān)閉內(nèi)循環(huán)風(fēng)扇的同時��,XTDIC三維全場應(yīng)變測量系統(tǒng)進(jìn)行圖像采集��,采集20s左右����,采集3組。分析曲線穩(wěn)定位置�����。實測:關(guān)閉風(fēng)扇后1.2s~2.5s內(nèi)數(shù)據(jù)分布最均勻��,數(shù)據(jù)波動最小。

4�、外部風(fēng)扇干擾
溫箱在升溫過程中,頂部玻璃視窗會產(chǎn)生熱氣流擾動���,需設(shè)計橫向吹風(fēng)的外部風(fēng)扇���,將熱氣流吹走。(判斷外部風(fēng)扇對數(shù)據(jù)影響)
外部風(fēng)扇干擾測試數(shù)據(jù)
將樣件升溫至100℃����,保持30min后,打開外部風(fēng)扇XTDIC系統(tǒng)采集一次���,關(guān)閉外部風(fēng)扇采集一次�����。每次間隔5min����,采集3組數(shù)據(jù)�,分析開關(guān)風(fēng)扇對測量數(shù)據(jù)的影響。每次采集5張圖像���,分析每次采集數(shù)據(jù)最大的應(yīng)變值�。(理論多張圖像計算數(shù)據(jù)應(yīng)越小越好)
實測數(shù)據(jù)表明:打開風(fēng)扇數(shù)據(jù)明顯更加穩(wěn)定�,且波動小。

DIC測試數(shù)據(jù)結(jié)果
采用新拓三維XTDIC三維全場應(yīng)變測量系統(tǒng)��,得到單晶硅材料試樣表面在升溫過程中的位移場�,下表可清晰地看到單晶硅材料在熱載荷作用下產(chǎn)生的變形量。
DIC軟件自帶熱膨脹CTE功能����,對單晶硅試樣進(jìn)行CTE分布分析。如下為單晶硅試樣升溫過程位移場分布:
表一

表二

表三

表四
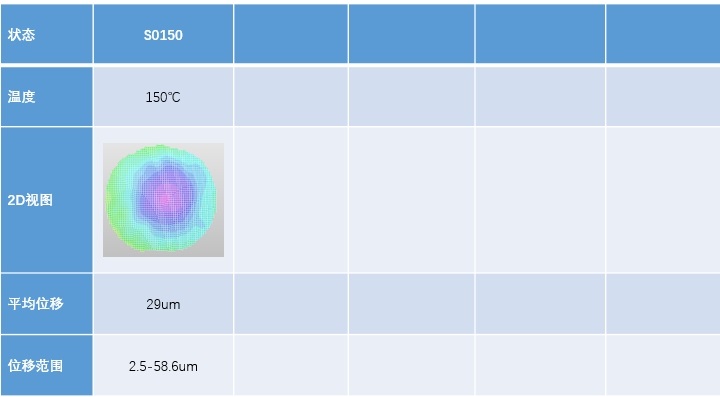
基礎(chǔ)狀態(tài)數(shù)據(jù)展示
基礎(chǔ)狀態(tài)數(shù)據(jù)�,是用來觀察DIC相機(jī)基礎(chǔ)幀數(shù)據(jù)跳動情況的指標(biāo),基礎(chǔ)幀的跳動數(shù)據(jù)�����,反映了整體設(shè)備采集過程中數(shù)據(jù)的變化程度���。
表五

采用新拓三維XTDIC三維全場應(yīng)變測量系統(tǒng)��,結(jié)合溫控箱熱加載方法���,實現(xiàn)高溫環(huán)境下的非接觸式變形測試��。DIC技術(shù)結(jié)合溫控箱��,從室溫到200℃的溫度加載�����,結(jié)合內(nèi)外循環(huán)風(fēng)扇排除熱氣流干擾���,具有溫度可控、DIC位移測試精確可靠等優(yōu)點(diǎn)��。
測試結(jié)論

XTDIC三維全場應(yīng)變測量系統(tǒng)實現(xiàn)了不同溫度環(huán)境下單晶硅試件表面的位移場分析���,測試數(shù)據(jù)表明:位移場隨溫度升高�,逐漸出現(xiàn)中心位移量小���,邊緣位移量大的遞增趨勢��,呈中心低邊緣高分布�����。單晶硅試件表面的熱變形為材料和結(jié)構(gòu)仿真分析提供數(shù)據(jù)驗證��,對于提高半導(dǎo)體器件的制造質(zhì)量和可靠性具有重要意義�。